本研究の一部は、独立行政法人新エネルギー・産業技術総合開発機構(NEDO)の委託事業である、平成23~25年度「省エネルギー革新技術開発事業 挑戦研究(事前研究一体型)/課題名:超高耐圧酸化ガリウムパワーデバイスの研究開発」により実施しました。
独立行政法人情報通信研究機構(理事長:坂内 正夫)は、株式会社タムラ製作所(代表取締役社長:田村 直樹)、株式会社光波(代表取締役社長:中島 康裕)と共同で、新しいワイドギャップ半導体材料である酸化ガリウム(Ga2O3)を用いた実用性に優れたMOSトランジスタの開発に世界に先駆けて成功しました。
Ga2O3は、そのワイドギャップに代表される材料物性から、高耐圧・低損失なパワーデバイス用途の新しい半導体材料として非常に有望です。また、酸化ガリウムは、シリコンカーバイド(SiC)、窒化ガリウム(GaN)といった既存のワイドギャップ半導体では不可能な融液成長法による単結晶基板の作製が可能であることから、基板サイズの拡大や、製造に必要なエネルギーやコストの大幅な削減が見込まれます。今回開発したGa2O3 MOSトランジスタは、そのまま実用可能といえる構造、特性を有します。そのため、現代の省エネルギー問題に直接貢献することができる新しい半導体デバイス研究開発分野における大きなブレークスルーであると同時に、近い将来の半導体産業の更なる発展につながることを期待させる成果です。
なお、本研究成果の詳細は、2013年6月24日(月)から米国ノートルダム大学で開催される半導体電子デバイスに関する国際会議「Device Research Conference (DRC2013)」にて、発表(レートニュース)を予定しています。
現在、世界的な課題として革新的な省電力技術の開発が求められています。このような社会事情から、現状のシリコン(Si) よりも更に高耐圧・低損失なパワーデバイスの実現が期待できるSiC、GaNといったワイドギャップ半導体材料が注目され、日本はもとより米国、欧州といった諸外国においても活発に研究開発が進められています。Ga2O3は、SiC、GaNよりも更に大きなバンドギャップに代表されるその物性から、パワーデバイスに応用した場合、より一層の高耐圧・低損失なデバイス特性が期待できます。また、融液成長法により簡便に単結晶基板が作製可能であるという、実際に基板を作製する上で非常に有益な特徴もあります。しかし、これらの高いポテンシャルにもかかわらず、未開拓の新半導体材料です。

今回、新たにGa2O3に合わせて開発したデバイスプロセス技術を駆使して、最も実用に適した電界効果トランジスタの一種であるMOSトランジスタを作製し、その動作実証に世界で初めて成功しました。今回開発した新技術の中での最大のポイントは、イオン注入及びゲート絶縁膜に関する技術です。その結果、デバイス特性は約2年前に報告したトランジスタ(MESFET)と比べて大幅に向上しました。具体的には、非常にシンプルなトランジスタ構造であるにもかかわらず、(1) 高いオン電流(39 mA/mm)、(2) 高いオフ状態耐圧(370 V以上)、(3) 非常に小さいリーク電流(測定限界数pA/mm以下)、(4) 高い電流オン/オフ比(10桁以上)など、パワートランジスタとして実用上要求される性能を十分に満たす特性が得られております。そのため、今回新たに開発に成功したGa2O3 MOSトランジスタを、実際のパワーデバイス機器に応用した場合、既存の半導体トランジスタと比較して、高い耐圧とスイッチング動作時の大幅な損失低減が期待されます。
今回、新ワイドギャップ半導体材料であるGa2O3を用いたMOSトランジスタの開発に成功したことにより、この新しい半導体材料の利用価値は大幅に膨らみ、また次世代高性能パワーデバイスの近い将来の実用化に対して道筋をつけることができました。今後、その優れた物性を生かしたGa2O3デバイスに関する研究開発が、世界的に急速かつ本格的に広がると予想されます。高性能Ga2O3パワーデバイスは、グローバルな課題である省エネ問題に対して直接貢献するとともに、日本発の新たな半導体産業の創出という経済面での貢献も併せて期待されます。近い将来、送配電、鉄道といった高耐圧から、電気、ハイブリッド自動車応用などの中耐圧、更にはエアコン、冷蔵庫といった家電機器などで用いられる低耐圧分野も含めた非常に幅広い領域での応用が見込まれます。
補足資料
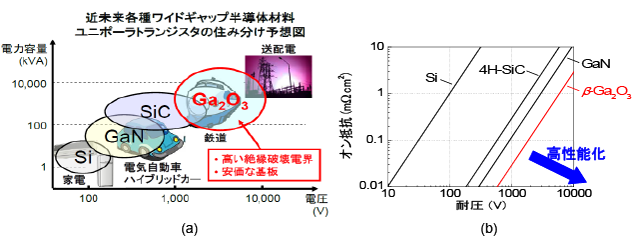
(b) パワーデバイスに用いられる代表的な半導体と酸化ガリウム(Ga2O3)のオン抵抗と耐圧の関係
図1(a)は、代表的な半導体及び酸化ガリウム(Ga2O3)の、主に物性値から見積もられた将来的な適用分野の住み分け予想図です。Ga2O3は、その物性からシリコンカーバイド(SiC)、窒化ガリウム(GaN)より、更に高耐圧、大電力分野で最初にその利用が進むと予想されます。その後、Ga2O3デバイスの普及に伴い、基板作製が簡便かつ安価で可能であることによるコスト面での有利さを活かして、さらに、SiC、GaNの分野へも利用が広がっていくと考えられます。
Ga2O3パワーデバイスの性能を決める2大パラメーターである「耐圧」と「オン抵抗」は、常にトレードオフの関係にあります。パワーデバイスには高耐圧・低損失が求められますが、高耐圧を得ようとするとオン抵抗が高くなり、発熱量が増加し損失が大きくなります。そのため、図1(b)に描く各々の材料の性能限界を示す直線に関しては、グラフ上、右下へ行くほどパワーデバイス材料として優れていることを表しています。同じ耐圧特性になるように設計した同様のトランジスタ構造において比較した場合、Ga2O3トランジスタは、現在主流のシリコン(Si)トランジスタと比較して損失(オン抵抗)が3,000分の1以下、また代表的なワイドギャップ半導体SiCと比較しても1/10程度に抑えることが可能と言えます。損失の低減量は、そのまま省エネ量に相当します。このように、Ga2O3は、Siはもとより代表的なワイドギャップ半導体であるGaN、SiCと比較しても、パワーデバイス材料として更に優れた特性を有していることが分かります。

図2は、融液成長法により作製した単結晶β-Ga2O3基板を示しています。融液成長法は、(1) 基板の大型化が容易、(2) 作製時に高温、高圧といった条件が必要でないことから、低エネルギー、低コストでの作製が可能、(3) 原料効率が高い等の特徴を持つことから、実際の生産に非常に適した方法です。単結晶Ga2O3基板が、他のワイドギャップ半導体材料(SiC、GaN)では不可能な融液成長法で作製可能であることは、実用面・産業面での大きなアドバンテージとなります。特に、Ga2O3基板の価格面でのアドバンテージは大きく、少なく見積もっても将来的にはSiCやGaN基板の1/10~1/100以下の価格になると考えられます。なお、パワーデバイスでは、一般的に基板のコストが最終的な製品の製造に要するコスト全体に占める割合が大きく、およそ6割程度となります。
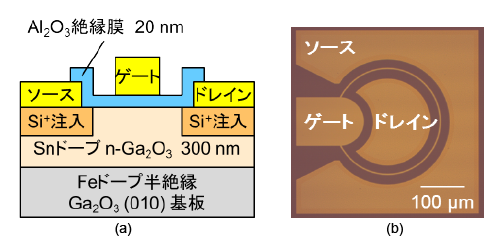
図3に示す、実用性に富むトランジスタ構造であるMOSFETを、今回新たに開発した(1) Siイオン注入による選択ドーピング技術、(2) 絶縁膜堆積技術(Al2O3絶縁膜)を用いて作製しました。
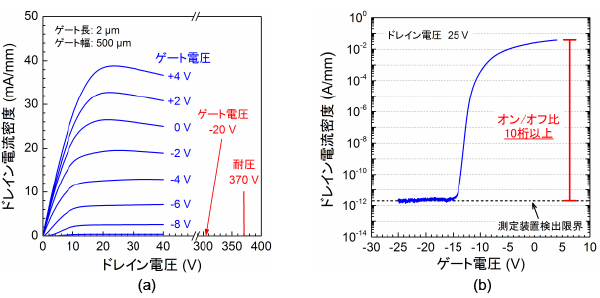
図4(a)の電流、電圧特性に示すように、ゲート電圧によるドレイン電流量及びオン・オフ制御が完璧になされています。また、ドレイン電流をオフにした状態で、耐圧370 Vが得られています。これは、耐圧向上対策を施していない非常に単純なFET構造であることも考慮した場合、非常に高い値と言えます。
また、図4(b)に示すように、トランジスタオフ時のドレインリーク電流が非常に小さいことも特徴です。このデバイスでは、リーク電流が測定装置の検出限界以下となっています。この結果、トランジスタ動作時のオン/オフ比も10桁以上と非常に高い値が得られています。オフ時のリーク電流が小さいことは、そのまま電力損失の低減につながります。単純なトランジスタ構造であるにもかかわらず、上述のようにパワーデバイスとして要求される重要な特性を既に満たすレベルにあります。Ga2O3の材料特性及び単結晶基板を用いたことによる結晶品質の高さと、今回新たに開発したプロセス技術のコンビネーションが、Ga2O3 MOSFETの優れたデバイス特性につながりました。
用語 解説
半導体の材料特性を決める最も基本的なパラメーターである「バンドギャップ」が大きい半導体の総称。バンドギャップに関しては、下記を参照。代表的なワイドギャップ半導体としては、シリコンカーバイド(SiC)、窒化ガリウム(GaN)、酸化亜鉛(ZnO)などが挙げられる。電子デバイスに応用する場合、高耐圧、高出力、低損失などのパワーデバイスに適した特性を示す。そのため、現在シリコン(Si)に替わる次世代パワーデバイス材料として盛んに研究開発が進められている。
酸化ガリウムは、ガリウム(Ga)と酸素(O)の化学量論比2:3の化合物で、化学式Ga2O3で表される半導体。結晶構造として、α, β, γ, δ, εの5つの異なる形が存在することが知られている。それらの中でも、最も安定な構造であるβ-Ga2O3のバンドギャップは室温で4.8-4.9 eV(電子ボルト)と非常に大きな値である。
MOSFET (Metal-Oxide-Semiconductor Field Effect Transistor)は、電界効果トランジスタの一種。ゲート金属と半導体の間に酸化物絶縁膜を挟んだ構造を持つ。この酸化物絶縁膜により、リーク電流を大幅に減少させることができ、その結果、トランジスタの高効率化につながる。シリコン (Si) MOSFETは、現在様々なエレクトロニクス用途で最も多く用いられている。
パワーデバイスは、電力機器向けの半導体素子の総称。その構造は電力制御用に最適化されており、パワーエレクトロニクスの中心となる電子部品。家庭用電化製品やコンピュータなどに使われている半導体素子に比べて、高電圧、大電流を扱えることが特徴となる。
シリコンカーバイドは、ケイ素(Si)と炭素(C)の1:1 の化合物で、化学式SiCで表される半導体。バンドギャップは室温で3.3 eV(電子ボルト)である。その大きなバンドギャップから、現在次世代パワーデバイス材料として活発に研究開発が進められている。
窒化ガリウムは、ガリウム(Ga)と窒素(N)の1:1の化合物で、化学式GaNで表される半導体。そのバンドギャップは室温で3.4 eV(電子ボルト)と大きい。現在、主に、青色発光ダイオード、レーザーダイオード等の発光デバイスの材料として用いられている。また、電子デバイスとしても、昨今SiCと同様に、パワーデバイス用途での研究開発が活発に進められている。
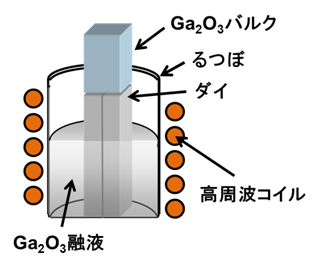
溶融した材料を用いた単結晶成長方法。半導体基板作製に適用した場合の特徴として、(1) 単結晶基板の大型化が容易、(2) 作製時に高温・高圧といった条件が不要なため低エネルギー・低コストでの作製が可能、(3) 原料効率が高い等が挙げられる。これらの特徴から、実際の生産に非常に適した方法である。
半導体、絶縁体において、電子が占有する最も高いエネルギーバンドである価電子帯の頂上と、最も低い空のバンドに相当する伝導帯の底までのエネルギー差。材料物性を決める最も基本的なパラメーターの一つ。
本件に関する 問い合わせ先
未来ICT研究所
東脇 正高
Tel: 042-327-6092
E-mail: 


















取材依頼及び広報 問い合わせ先
廣田 幸子
Tel: 042-327-6923
E-mail: 



















コアテクノロジー本部
コーポレート情報統括部
竹内 夏美
Tel: 03-3978-2012
E-mail: 






































