Successful Development of World’s First Vertical Ga2O3 Transistor through Low-Cost, Highly-Manufacturable Ion Implantation Doping Process
December 12, 2018
National Institute of Information and Communications Technology
Tokyo University of Agriculture and Technology
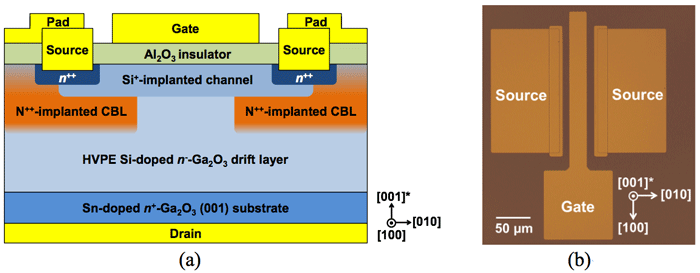
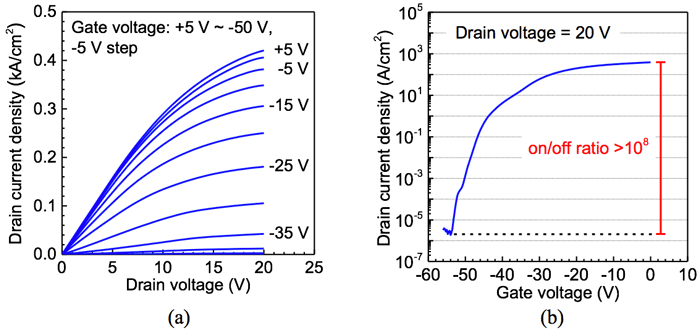
Publication Information
References
Technical Contact
Masataka Higashiwaki
Green ICT Device Advanced Development Center
Advanced ICT Research Institute
National Institute of Information and Communications Technology
Tel: +81-42-327-6092
E-mail:



















Yoshinao Kumagai
Department of Applied Chemistry
Tokyo University of Agriculture and Technology
Tel: +81-42-388-7469
E-mail:






















Media Contact
Sachiko Hirota
Press Office
Public Relations Department
National Institute of Information and Communications Technology
Tel: +81-42-327-6923
E-mail:




















Public Relations and Endowment Office
General Affairs Office
General Affairs Division
Tokyo University of Agriculture and Technology
Tel: +81-42-367-5930
E-mail:




















