主なミリ波デバイス開発用プロセス装置:詳細
プロセス装置
メタルスパッタ装置
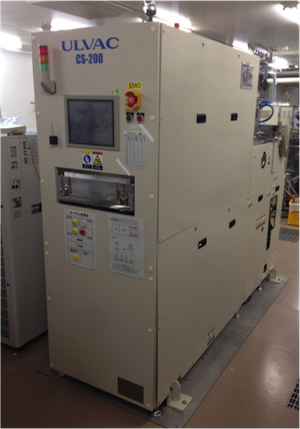
製造元:アルバックテクノ(株)
型 式:CS-200
用 途:誘電体薄膜形成
仕 様
ウェハサイズ:小片~300mm径
スパッタ・成膜方式:デポダウン(スパッタ成膜面は上向き、カソード面は下向き)
プレーナ・マグネトロン・カソード:3式(非磁性体用、4インチ径)1式(磁性体用、4インチ径)
DC電源(最大):2.0kW
RF電源(最大):1.0kW(DC/RFの同時・重畳放電は不可)
放電可能圧力:0.1~1.5 Pa
基板温度(最大):300℃
ターゲット・基板間距離:60~160mm(可変)
主排気:ターボ分子ポンプ
ロードロック機構: 有
導入ガス:Ar、N2
スパッタ材料:Ta、Mo、Ni、Ti、Al、SiO2
型 式:CS-200
用 途:誘電体薄膜形成
仕 様
ウェハサイズ:小片~300mm径
スパッタ・成膜方式:デポダウン(スパッタ成膜面は上向き、カソード面は下向き)
プレーナ・マグネトロン・カソード:3式(非磁性体用、4インチ径)1式(磁性体用、4インチ径)
DC電源(最大):2.0kW
RF電源(最大):1.0kW(DC/RFの同時・重畳放電は不可)
放電可能圧力:0.1~1.5 Pa
基板温度(最大):300℃
ターゲット・基板間距離:60~160mm(可変)
主排気:ターボ分子ポンプ
ロードロック機構: 有
導入ガス:Ar、N2
スパッタ材料:Ta、Mo、Ni、Ti、Al、SiO2
EB蒸着装置
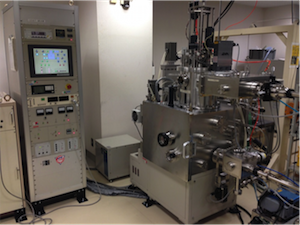
製造元:正和ハイテック
型 式:S100
用 途:金属薄膜の真空堆積・蒸着
仕 様
堆積・成膜方式:フェースダウン(堆積・成膜面は下向き、EBボート・蒸着ボートは上向き)
EBボート数:6
蒸着ボート電極数:2
主排気:クライオポンプ、ターボ分子ポンプ
基板ホルダ回転機構:有
ロードロック機構:有
蒸着材料(EBボート):Ti、W、Ni、Al2O3、Mo、Si、Pt
蒸着材料(蒸着ボート):Au、AuGe、Ni、Cu、Al等
型 式:S100
用 途:金属薄膜の真空堆積・蒸着
仕 様
堆積・成膜方式:フェースダウン(堆積・成膜面は下向き、EBボート・蒸着ボートは上向き)
EBボート数:6
蒸着ボート電極数:2
主排気:クライオポンプ、ターボ分子ポンプ
基板ホルダ回転機構:有
ロードロック機構:有
蒸着材料(EBボート):Ti、W、Ni、Al2O3、Mo、Si、Pt
蒸着材料(蒸着ボート):Au、AuGe、Ni、Cu、Al等
小型抵抗蒸着装置

製造元:北野精機(株)
型 式:RFS-1500SZ,RFS-1800SZ
用 途:金属薄膜の真空堆積・蒸着
仕 様
堆積・成膜方式:フェースダウン(堆積・成膜面は下向き、EBボート・蒸着ボートは上向き)
ボート型ヒーターによる上向き堆積
電極数:4(スイッチによる切替え)
主排気:ターボ分子ポンプ
基板ホルダ回転機構:無
バルブ開閉機構:手動
チャンバー開閉:手動クレーン
蒸着材料:Au、AuGe、Ni、Cu、Ti等
型 式:RFS-1500SZ,RFS-1800SZ
用 途:金属薄膜の真空堆積・蒸着
仕 様
堆積・成膜方式:フェースダウン(堆積・成膜面は下向き、EBボート・蒸着ボートは上向き)
ボート型ヒーターによる上向き堆積
電極数:4(スイッチによる切替え)
主排気:ターボ分子ポンプ
基板ホルダ回転機構:無
バルブ開閉機構:手動
チャンバー開閉:手動クレーン
蒸着材料:Au、AuGe、Ni、Cu、Ti等
P-CVD装置

製造元: サムコ(株)製
型 式: PD-240
用 途:SiO2膜の形成
仕 様
基板サイズ(最大):200mm径
方式:液体ソース(TEOS)プラズマCVD
RF出力(最大):300W、13.56MHz
基板温度(最大):400℃
ロードロック機構:有
導入ガス:TEOS、CF4、N2、O2
電子ビーム露光装置
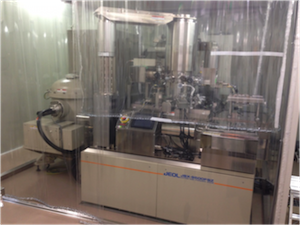
製造元:日本電子(株)
型 式:JBX-9500FSZ
用 途:電子ビームによるレジスト描画・露光
仕 様
ウェハサイズ:15mm角~300mm径
電子銃:ZrO/Wショットキー型(熱電界放射型)
加速電圧:100kV(固定)
ビーム形状:スポット(ガウシアン)ビーム
ビーム径:3.2nm以下(加速電圧100kV時)
ビーム電流:0.3pA~100nA
描画・露光方式:ベクタースキャン方式
フィールドサイズ:1mm角
型 式:JBX-9500FSZ
用 途:電子ビームによるレジスト描画・露光
仕 様
ウェハサイズ:15mm角~300mm径
電子銃:ZrO/Wショットキー型(熱電界放射型)
加速電圧:100kV(固定)
ビーム形状:スポット(ガウシアン)ビーム
ビーム径:3.2nm以下(加速電圧100kV時)
ビーム電流:0.3pA~100nA
描画・露光方式:ベクタースキャン方式
フィールドサイズ:1mm角
マスクアライナー
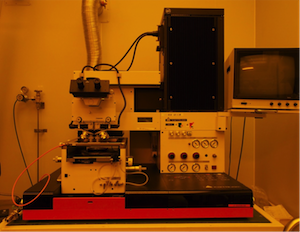
微細パターンのマスクとレジスト膜を塗布した試料基板を密着させ、紫外線により露光する装置。
製造元:KarlSuss
型 式:MA-6
仕 様
露光光源:超高圧水銀灯350W
最大基板口径:6インチ径
実用解像度:1μm
製造元:KarlSuss
型 式:MA-6
仕 様
露光光源:超高圧水銀灯350W
最大基板口径:6インチ径
実用解像度:1μm
RIEエッチング装置(F系、Cl系)
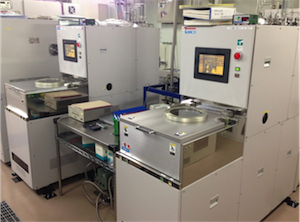
製造元:サムコ(株)
型 式:RIE-200L
用 途:化合物半導体・絶縁膜のドライエッチング
仕 様
ウェハサイズ(最大):8インチ径
RF出力(最大):300W、13.56MHz
主排気:ターボ分子ポンプ
ロードロック機構:有
プラズマプロセスモニタ:有
導入ガス(F系):CF4、SF6、CHF3、O2、Ar
導入ガス(Cl系):Cl2、BCl3、Ar、O2
エッチング可能材料:化合物半導体、絶縁膜
型 式:RIE-200L
用 途:化合物半導体・絶縁膜のドライエッチング
仕 様
ウェハサイズ(最大):8インチ径
RF出力(最大):300W、13.56MHz
主排気:ターボ分子ポンプ
ロードロック機構:有
プラズマプロセスモニタ:有
導入ガス(F系):CF4、SF6、CHF3、O2、Ar
導入ガス(Cl系):Cl2、BCl3、Ar、O2
エッチング可能材料:化合物半導体、絶縁膜
バレル型プラズマ処理装置

製造元:サムコ(株)
型 式:PM-631
用 途:基板表面洗浄、残渣有機物除去
仕 様
ウェハサイズ:小片(数mm角)~8インチ径
方式:ダイレクト・プラズマ方式
反応室:バレル型(石英)、φ317mm×780mm
電極構造:外部容量結合型電極(アルミ製)
RF出力:100~1000W、13.56MHz
主排気:ロータリーポンプ
導入ガス:O2、N2
型 式:PM-631
用 途:基板表面洗浄、残渣有機物除去
仕 様
ウェハサイズ:小片(数mm角)~8インチ径
方式:ダイレクト・プラズマ方式
反応室:バレル型(石英)、φ317mm×780mm
電極構造:外部容量結合型電極(アルミ製)
RF出力:100~1000W、13.56MHz
主排気:ロータリーポンプ
導入ガス:O2、N2
ICPメタルエッチング装置

製造元:サムコ(株)
型 式:RIE-140iPJ
用 途:金属薄膜・化合物半導体のドライエッチング
仕 様
ウェハサイズ(最大):4インチ径
放電方式:トルネード型誘導結合方式(ICP)
ICP出力:50~500W、13.56MHz
RF出力:30~300W、13.56MHz
プロセス圧力:0.1~13.3 Pa
電極温度:20~200℃(オイルチラー方式)
主排気:ターボ分子ポンプ
ロードロック機構:有
干渉式リアルタイム膜厚モニタ:有
プラズマ発光分析器:有
導入ガス:HBr、SiCl4、BCl3、Cl2、O2、Ar
エッチング可能材料:金属薄膜、化合物半導体
型 式:RIE-140iPJ
用 途:金属薄膜・化合物半導体のドライエッチング
仕 様
ウェハサイズ(最大):4インチ径
放電方式:トルネード型誘導結合方式(ICP)
ICP出力:50~500W、13.56MHz
RF出力:30~300W、13.56MHz
プロセス圧力:0.1~13.3 Pa
電極温度:20~200℃(オイルチラー方式)
主排気:ターボ分子ポンプ
ロードロック機構:有
干渉式リアルタイム膜厚モニタ:有
プラズマ発光分析器:有
導入ガス:HBr、SiCl4、BCl3、Cl2、O2、Ar
エッチング可能材料:金属薄膜、化合物半導体
赤外線ランプ加熱装置

製造元:アルバック理工(株)
型 式:RTP-6
用 途:オーミック電極形成の急速熱処理
仕 様
ウェハサイズ(最大):6インチ径
プロセス温度:室温~1000 ℃
加熱方式:放物面反射赤外線ランプによる上面片面加熱
加熱速度(最大):50℃/秒
加熱制御方式:フィードバック方式(クリーズドループ制御)
加熱雰囲気:ガス中、ガスフロー中、大気中
冷却方式:メタルチャンバー式コールドウォール構造による急速冷却
主排気:スクロールポンプ
導入ガス:N2
型 式:RTP-6
用 途:オーミック電極形成の急速熱処理
仕 様
ウェハサイズ(最大):6インチ径
プロセス温度:室温~1000 ℃
加熱方式:放物面反射赤外線ランプによる上面片面加熱
加熱速度(最大):50℃/秒
加熱制御方式:フィードバック方式(クリーズドループ制御)
加熱雰囲気:ガス中、ガスフロー中、大気中
冷却方式:メタルチャンバー式コールドウォール構造による急速冷却
主排気:スクロールポンプ
導入ガス:N2
表面微細形状計測装置
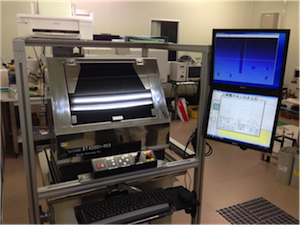
製造元:ミカサ(株)
型 式:ET4000A-MKS
用 途:表面の段差、表面粗さ、微細形状を計測
仕 様
試料サイズ(最大):200mm角
検出器センサー:直動式差動変圧器
検出器センサー測定範囲(最大):100μm
スタイラス針圧:0.1~50mgf
測定項目:微細形状、段差、粗さ、うねり
型 式:ET4000A-MKS
用 途:表面の段差、表面粗さ、微細形状を計測
仕 様
試料サイズ(最大):200mm角
検出器センサー:直動式差動変圧器
検出器センサー測定範囲(最大):100μm
スタイラス針圧:0.1~50mgf
測定項目:微細形状、段差、粗さ、うねり
【基板加工装置】
レーザーソー

製造元:(株)ディスコ
型 式:DFL7560V
用 途:レーザーダイシング・ビア形成
仕 様
ワークサイズ(最大):6インチ径
対応フレーム:2-6-1
レーザー波長:約350nm
パルス繰り返し周波数(最大):200kHz
レーザー出力(最大):10W(出射口)約8W(加工点)
ビームスポット径(代表値):約50 μm
ステージ速度(最大):1m/s
加工方法:ビア形成、グルービング、フルカット、HASENカット
加工可能材料:Si、GaAs、InP、GaN、SiC、LN、サファイア、セラミック等
型 式:DFL7560V
用 途:レーザーダイシング・ビア形成
仕 様
ワークサイズ(最大):6インチ径
対応フレーム:2-6-1
レーザー波長:約350nm
パルス繰り返し周波数(最大):200kHz
レーザー出力(最大):10W(出射口)約8W(加工点)
ビームスポット径(代表値):約50 μm
ステージ速度(最大):1m/s
加工方法:ビア形成、グルービング、フルカット、HASENカット
加工可能材料:Si、GaAs、InP、GaN、SiC、LN、サファイア、セラミック等
ダイシングソー
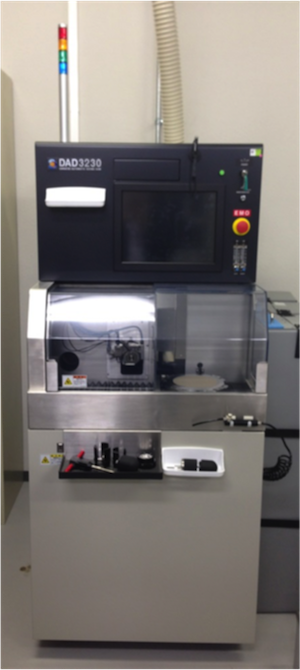
製造元:(株)ディスコ
型 式:DAD3230
用 途:ダイシング
仕 様
ワークサイズ(最大):6インチ径
対応フレーム:2-6-1
対応ブレード:2インチハブブレード2インチハブレス(ワッシャ)ブレード
最大ブレード厚:1mm
スピンドル回転数:3000~40000rpm
ブレード破損検出器:有
純水リサイクル装置(ディスコ(株)製DWR1721)による切削水・冷却水供給、排水処理
切削可能材料:Si、GaAs、InP、GaN、SiC、LN、サファイア、セラミック等(但し、ブレード仕様に依存)
導入ガス:N2
型 式:DAD3230
用 途:ダイシング
仕 様
ワークサイズ(最大):6インチ径
対応フレーム:2-6-1
対応ブレード:2インチハブブレード2インチハブレス(ワッシャ)ブレード
最大ブレード厚:1mm
スピンドル回転数:3000~40000rpm
ブレード破損検出器:有
純水リサイクル装置(ディスコ(株)製DWR1721)による切削水・冷却水供給、排水処理
切削可能材料:Si、GaAs、InP、GaN、SiC、LN、サファイア、セラミック等(但し、ブレード仕様に依存)
導入ガス:N2
バックグラインダ

製造元:(株)ディスコ
型 式:DAG810
用 途:バックグライディング(裏面研削・薄化加工)
仕 様
ワークサイズ(最大):8インチ径
研削可能ワーク厚さ(最大):20mm
対応フレーム:2-6-1、2-8-1
研削方法:インフィード
研削厚さ測定:ハイトゲージによるインプロセス制御
スピンドル回転数:1000~7000rpm
チャックテーブル回転数:0~300rpm
純水リサイクル装置(ディスコ(株)製DWR1721)による研削水・冷却水供給、排水処理
研削可能材料:Si、化合物半導体等(但し、ホイール仕様に依存)
型 式:DAG810
用 途:バックグライディング(裏面研削・薄化加工)
仕 様
ワークサイズ(最大):8インチ径
研削可能ワーク厚さ(最大):20mm
対応フレーム:2-6-1、2-8-1
研削方法:インフィード
研削厚さ測定:ハイトゲージによるインプロセス制御
スピンドル回転数:1000~7000rpm
チャックテーブル回転数:0~300rpm
純水リサイクル装置(ディスコ(株)製DWR1721)による研削水・冷却水供給、排水処理
研削可能材料:Si、化合物半導体等(但し、ホイール仕様に依存)
ウェハ洗浄装置

製造元:(株)ディスコ
型 式:DCS1440
用 途:半導体ウェハの洗浄
仕 様
ワークサイズ(最大):6インチ径
対応フレーム:2-6-1
洗浄方式:二流体洗浄
洗浄シーケンス:任意設定可能(アーム旋回スピード、洗浄箇所)
純水リサイクル装置(ディスコ(株)製DWR1721)による洗浄水供給、排水処理
型 式:DCS1440
用 途:半導体ウェハの洗浄
仕 様
ワークサイズ(最大):6インチ径
対応フレーム:2-6-1
洗浄方式:二流体洗浄
洗浄シーケンス:任意設定可能(アーム旋回スピード、洗浄箇所)
純水リサイクル装置(ディスコ(株)製DWR1721)による洗浄水供給、排水処理
走査型電子顕微鏡
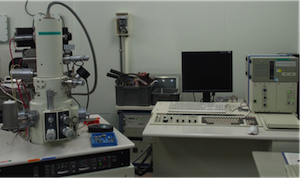
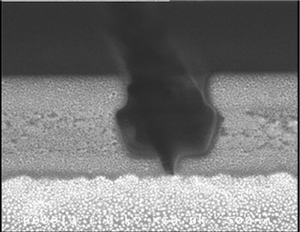
[電界放射型SEM]加速電圧1kVにおいても,実用倍率10万倍の高倍率電子顕微鏡。最大2インチウェハ相当の大きさのサンプルまで観察可能。主として断面構造の観察に使用している。
製造元:日立製作所
型 式:S4500
仕 様
FE(電界放射)型電子銃
セミインレンズ方式
最大加速電圧30kV
製造元:日立製作所
型 式:S4500
仕 様
FE(電界放射)型電子銃
セミインレンズ方式
最大加速電圧30kV
赤外線分光装置(FT-IR)
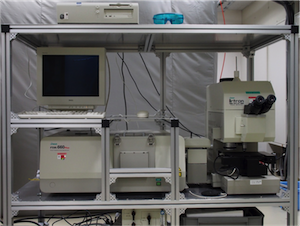
フーリエ変換赤外線分光装置試料の赤外線領域での透過率スペクトルを測定する。フーリエ変換によりスペクトルを測定するので、短時間に測定が可能である。真空排気可能な通常の資料室に加え、微小領域の観察が可能な顕微鏡を備えている。
製造元:日本分光
型 式:HR660
仕 様
測定範囲:7800?350 cm-1
分解能:0.5 cm-1
S/N:25000
製造元:日本分光
型 式:HR660
仕 様
測定範囲:7800?350 cm-1
分解能:0.5 cm-1
S/N:25000
ラマン分光装置

ラマン分光装置入射光と異なる散乱光のスペクトルを測定する事により、物質の同定や物質のエネルギ準位を求める。
また、結晶性の評価にも用いられる
製造元:JobinYvon
型 式:HR800
仕 様
光源:Arレーザ(488nm)
分解能:0.35/cm
対物レンズ倍率:×10,×50,×100
また、結晶性の評価にも用いられる
製造元:JobinYvon
型 式:HR800
仕 様
光源:Arレーザ(488nm)
分解能:0.35/cm
対物レンズ倍率:×10,×50,×100
高周波測定装置
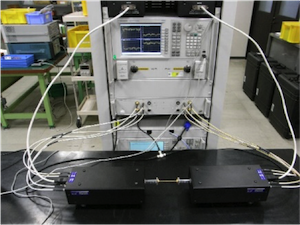
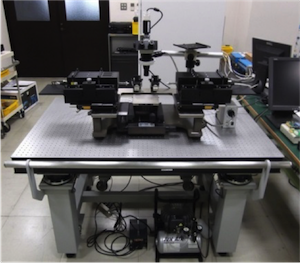
ネットワークアナライザ 製造元:キーサイト・テクノロジー
型 式:PNA, PNA-X
用 途:Sパラメータ測定
周波数:10MHz~67GHz
周波数エクステンダ
製造元:VDI社まはたOML社
用 途: Sパラ測定の周波数アップコンバージョン
周波数:60-1100GHzの各導波管バンド
各種プローバ(オンウエハ測定)
半導体パラメータアナライザ
電波暗室(伝搬計測システム)
基本測定器類
(オシロスコープ、スペクトルアナライザ、信号源、ロジックアナライザ、電力計、等)
型 式:PNA, PNA-X
用 途:Sパラメータ測定
周波数:10MHz~67GHz
周波数エクステンダ
製造元:VDI社まはたOML社
用 途: Sパラ測定の周波数アップコンバージョン
周波数:60-1100GHzの各導波管バンド
各種プローバ(オンウエハ測定)
半導体パラメータアナライザ
電波暗室(伝搬計測システム)
基本測定器類
(オシロスコープ、スペクトルアナライザ、信号源、ロジックアナライザ、電力計、等)
小型高速テラヘルツ時間領域分光装置(二機種)

製造元:(株)アドバンテスト
型 式:TAS7500SP x1,TAS7500SU x1
用 途:テラヘルツ領域における材料特性の計測(透過・反射等の分光解析)
仕 様
TAS7500SP
周波数レンジ:0.1~4THz
TAS7500SU
周波数レンジ:0.5~7THz
〔共通〕
周波数確度:±10GHz以下(1.4THzにて)
周波数分解能:7.6GHz
ダイナミックレンジ:70dB以上(ピーク周波数にて)
スループット:8ms/scan
試料寸法:透過/反射:φ5~30mm, 厚さ10mm以下
型 式:TAS7500SP x1,TAS7500SU x1
用 途:テラヘルツ領域における材料特性の計測(透過・反射等の分光解析)
仕 様
TAS7500SP
周波数レンジ:0.1~4THz
TAS7500SU
周波数レンジ:0.5~7THz
〔共通〕
周波数確度:±10GHz以下(1.4THzにて)
周波数分解能:7.6GHz
ダイナミックレンジ:70dB以上(ピーク周波数にて)
スループット:8ms/scan
試料寸法:透過/反射:φ5~30mm, 厚さ10mm以下
問合せ
お問い合わせは右記先端ICTデバイスラボ事務局へお願いいたします。
土曜、日曜、祝祭日については受付をしておりません。電子メールは常時受信可能ですが、お問い合わせへのお返事は休日明け以降となります。
-
メールアドレスAICT.inquiry@ml.nict.go.jp
-
郵便等宛先〒184-8795
東京都小金井市貫井北町4-2-1
国立研究開発法人 情報通信研究機構
先端ICTデバイスラボ 事務局