主な光デバイス開発用プロセス装置:詳細
プロセス装置
スピンコータ
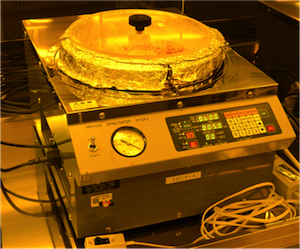
製造元:ミカサ(株)
型 式: IH-DX2
用 途: ホトレジスト塗布
仕 様
型式:回転塗布式
回転数: 300-7000rpm
回転制御:プログラム方式
回転時間:最大999.9秒
試料サイズ:154mmφ(MAX)
型 式: IH-DX2
用 途: ホトレジスト塗布
仕 様
型式:回転塗布式
回転数: 300-7000rpm
回転制御:プログラム方式
回転時間:最大999.9秒
試料サイズ:154mmφ(MAX)
露光装置
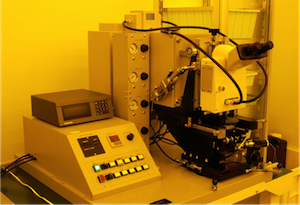
製造元: ミカサ(株)
型 式: MA-20
用 途: パターン転写
仕 様
露光方式:マスク密着型
顕微鏡:双対物型双眼
光源:超高圧水銀ランプ
マスクサイズ:最大5インチ
ウエファサイズ:φ1~φ4インチ
型 式: MA-20
用 途: パターン転写
仕 様
露光方式:マスク密着型
顕微鏡:双対物型双眼
光源:超高圧水銀ランプ
マスクサイズ:最大5インチ
ウエファサイズ:φ1~φ4インチ
ドラフトチャンバー
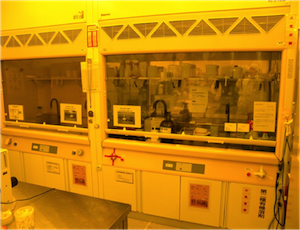
製造元: ヤマト化学(株)
型 式: RFS-1500SZ,RFS-1800SZ
用 途:化学薬品を使用した洗浄、エッチング処理、レジスト現像、有機溶剤による洗浄等
超音波洗浄器
超純水供給設備 2個所
型 式: RFS-1500SZ,RFS-1800SZ
用 途:化学薬品を使用した洗浄、エッチング処理、レジスト現像、有機溶剤による洗浄等
超音波洗浄器
超純水供給設備 2個所
ICPドライエッチング装置
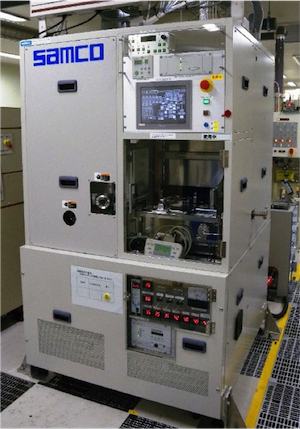
製造元: サムコ(株)製
型 式: RIE-101iPHJF
用 途: GaAs,InP等化合物半導体のドライエッチング
仕 様
放電方式:ICP型高密度プラズマ
RF出力:ICP 1KW(MAX) 13.56MHz
BIAS 300KW(MAX) 13.56MHz
主排気:ターボ分子ポンプ
試料ホルダ: 100 mmφ MAX
ロードロック機構付
基板加熱:オイルチラー方式(200℃ MAX)
導入ガス: Cl2, BCl3, SicL4
型 式: RIE-101iPHJF
用 途: GaAs,InP等化合物半導体のドライエッチング
仕 様
放電方式:ICP型高密度プラズマ
RF出力:ICP 1KW(MAX) 13.56MHz
BIAS 300KW(MAX) 13.56MHz
主排気:ターボ分子ポンプ
試料ホルダ: 100 mmφ MAX
ロードロック機構付
基板加熱:オイルチラー方式(200℃ MAX)
導入ガス: Cl2, BCl3, SicL4
P-CVD装置
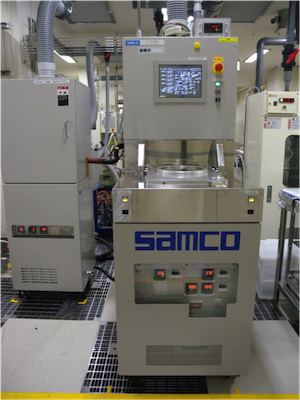
製造元: サムコ(株)
型 式: PD-220NLJ
用 途: SiO2膜の形成v
仕 様
方式:液体ソース(TEOS)プラズマCVD
RF出力: 300W(MAX)13.56MHz
排気:メカニカルブースターポンプ
ロードロック機構付
基板温度 : 400℃(MAX)
基板サイズ:200mmφ(MAX)
接続ガス:TEOS, O2,CF4
型 式: PD-220NLJ
用 途: SiO2膜の形成v
仕 様
方式:液体ソース(TEOS)プラズマCVD
RF出力: 300W(MAX)13.56MHz
排気:メカニカルブースターポンプ
ロードロック機構付
基板温度 : 400℃(MAX)
基板サイズ:200mmφ(MAX)
接続ガス:TEOS, O2,CF4
RFスパッタ装置
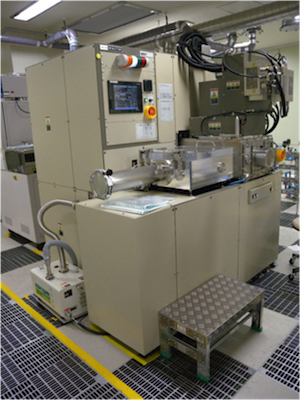
製造元: キャノンアネルバ(株)
型 式: EB1100
用 途: 誘電体薄膜形成
仕 様
平行平板型上部基板取り付けタイプ
主排気:ターボ分子ポンプ
RFパワー:300W(MAX)
カソード数:プレーナ型マグネトロン4基
基板加熱機構:300℃MAX
ロードロック式
多層膜自動堆積
成膜エリア:220ミリ以下
適応: SiO2,TiO2,Al2O3 等
型 式: EB1100
用 途: 誘電体薄膜形成
仕 様
平行平板型上部基板取り付けタイプ
主排気:ターボ分子ポンプ
RFパワー:300W(MAX)
カソード数:プレーナ型マグネトロン4基
基板加熱機構:300℃MAX
ロードロック式
多層膜自動堆積
成膜エリア:220ミリ以下
適応: SiO2,TiO2,Al2O3 等
段差測定器
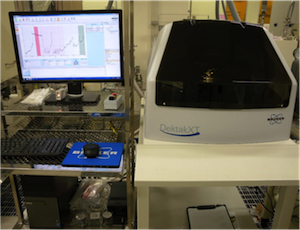
製造元: ブルカー・エイエックスエス
型 式: Dektak XT
用 途: 2次元表面プロファイル測定、基板表面形状、薄膜厚み、エッチング深さ等
仕 様
測定方式:針移動による表面接触式
スキャン長:55mm
段差測定再現性:<5Å
高さ分解能:1Åmax
触圧範囲:1~15mg
最大サンプル高さ:50mm
最大ウエハサイズ:200mm
型 式: Dektak XT
用 途: 2次元表面プロファイル測定、基板表面形状、薄膜厚み、エッチング深さ等
仕 様
測定方式:針移動による表面接触式
スキャン長:55mm
段差測定再現性:<5Å
高さ分解能:1Åmax
触圧範囲:1~15mg
最大サンプル高さ:50mm
最大ウエハサイズ:200mm
分光エリプソメータ
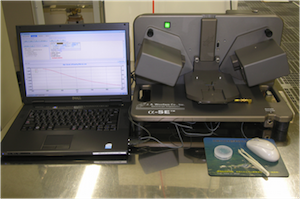
製造元: J.A.Woollam
型 式: α-SE
用 途: 薄膜厚み、光学定数の波長分散測定
仕 様
波長範囲:382~890nm
測定チャンネル:180
解析モデル:Causy,Lorentz等
試料サイズ:150×150mm,厚さ10mm(MAX)
型 式: α-SE
用 途: 薄膜厚み、光学定数の波長分散測定
仕 様
波長範囲:382~890nm
測定チャンネル:180
解析モデル:Causy,Lorentz等
試料サイズ:150×150mm,厚さ10mm(MAX)
ICPドライエッチング装置
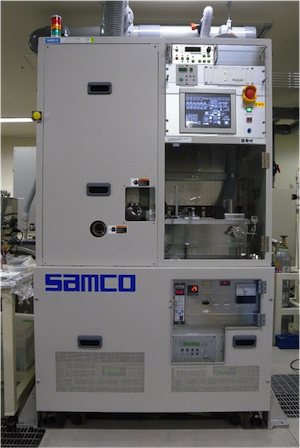
製造元: サムコ(株)製
型 式: RIE-101iPHJF
用 途: シリコン、酸化膜、金属等のエッチング
仕 様
放電方式:ICP型高密度プラズマ
RF出力:ICP 1KW(MAX) 13.56MHz
BIAS 300KW(MAX) 13.56MHz
主排気:ターボ分子ポンプ
試料ホルダ: 100 mmφ MAX
ロードロック機構付
基板加熱:オイルチラー方式(200℃ MAX)
導入ガス: CF4, O2, Ar, C3F8
型 式: RIE-101iPHJF
用 途: シリコン、酸化膜、金属等のエッチング
仕 様
放電方式:ICP型高密度プラズマ
RF出力:ICP 1KW(MAX) 13.56MHz
BIAS 300KW(MAX) 13.56MHz
主排気:ターボ分子ポンプ
試料ホルダ: 100 mmφ MAX
ロードロック機構付
基板加熱:オイルチラー方式(200℃ MAX)
導入ガス: CF4, O2, Ar, C3F8
プラズマドライクリーニング装置

製造元: サムコ(株)
型 式: PC-300J
用 途: 基板表面洗浄、残渣有機物除去
仕 様
RF出力:300w(MAX) 13.56MHz
基板サイズ:最大8インチφ
連続運転時間:99min(MAX)
RIEモード/プラズマエッチングモードが選択可能
接続ガス: O2,Ar,O2
型 式: PC-300J
用 途: 基板表面洗浄、残渣有機物除去
仕 様
RF出力:300w(MAX) 13.56MHz
基板サイズ:最大8インチφ
連続運転時間:99min(MAX)
RIEモード/プラズマエッチングモードが選択可能
接続ガス: O2,Ar,O2
抵抗加熱蒸着装置
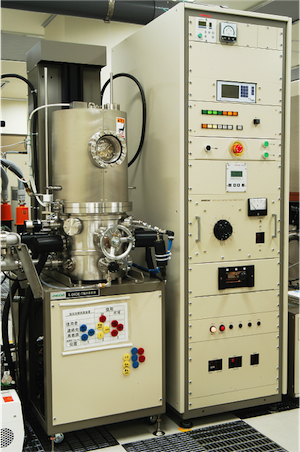
製造元: キャノンアネルバ(株)
型 式: L-043E
用 途: 金属薄膜の堆積
仕 様
下側電極数:3(スイッチによる切り替え)
ボート型ヒーターによる上向き堆積
主排気:ターボ分子ポンプ
バルブ開閉は全てマニュアル式
チャンバー開閉:上下電動式
基板ホルダ回転機構:無
適応:Au, AuZnNi, AuGeNi
型 式: L-043E
用 途: 金属薄膜の堆積
仕 様
下側電極数:3(スイッチによる切り替え)
ボート型ヒーターによる上向き堆積
主排気:ターボ分子ポンプ
バルブ開閉は全てマニュアル式
チャンバー開閉:上下電動式
基板ホルダ回転機構:無
適応:Au, AuZnNi, AuGeNi
電子ビーム(EB)蒸着装置
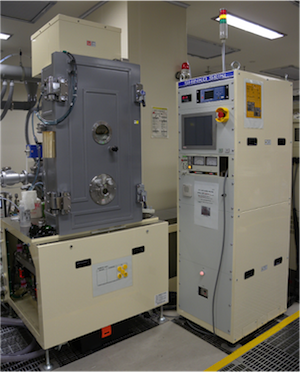
製造元: 神港精機(株)
型 式: AAMF-C1050SB
用 途: 金属薄膜形成
仕 様
主排気:クライオポンプ
電子銃:10kw6連
基板ホルダ:3インチφ 6枚
金属膜の多層自動堆積可
適応:Ti, Pt, Au, Ni, Cr 等
型 式: AAMF-C1050SB
用 途: 金属薄膜形成
仕 様
主排気:クライオポンプ
電子銃:10kw6連
基板ホルダ:3インチφ 6枚
金属膜の多層自動堆積可
適応:Ti, Pt, Au, Ni, Cr 等
シンター炉
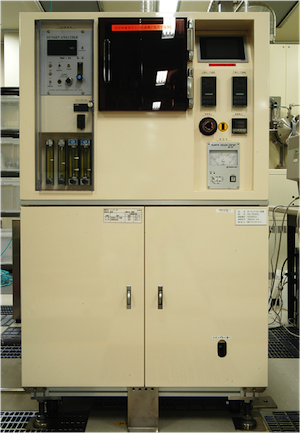
製造元: ケミトロニクス(株)
型 式: OS-3500E
用 途: オーミック電極形成用熱処理(N2 雰囲気中)
仕 様
プロセス温度:~600 ℃(MAX)
ウエファサイズ:3インチφ(MAX)
その他:ウエファ25枚カセット、自動搬送にて加熱処理が可能。
型 式: OS-3500E
用 途: オーミック電極形成用熱処理(N2 雰囲気中)
仕 様
プロセス温度:~600 ℃(MAX)
ウエファサイズ:3インチφ(MAX)
その他:ウエファ25枚カセット、自動搬送にて加熱処理が可能。
問合せ
お問い合わせは右記先端ICTデバイスラボ事務局へお願いいたします。
土曜、日曜、祝祭日については受付をしておりません。電子メールは常時受信可能ですが、お問い合わせへのお返事は休日明け以降となります。
-
メールアドレスAICT.inquiry@ml.nict.go.jp
-
郵便等宛先〒184-8795
東京都小金井市貫井北町4-2-1
国立研究開発法人 情報通信研究機構
先端ICTデバイスラボ 事務局